歐姆接觸
歐姆接觸是半導體設備上具有線性並且對稱的電流-電壓特性曲線(I-V curve)的區域。如果電流-電壓特性曲線不是線性的,這種接觸便叫做蕭特基接觸。典型的歐姆接觸是濺鍍或者蒸鍍的金屬片,這些金屬片通過曝光製程佈局。低電阻,穩定接觸的歐姆接觸是影響積體電路性能和穩定性的關鍵因素。它們的製備和描繪是電路製造的主要工作。
理論[編輯]
任何兩種相接觸的固體的費米能階(Fermi level,或者嚴格意義上,化學勢)必須相等。 費米能階和真空能階的差值稱作功函數。接觸金屬和半導體具有不同的功函數,分別記為和。當兩種材料相接觸時,電子將會從低功函(高Fermi level)一邊流向另一邊直到費米能階相平衡。從而,低功函(高Fermi level)的材料將帶有少量正電荷而高功函(低Fermi level)材料則會變得具有少量負電荷。最終得到的靜電勢稱為內建場記為。這種接觸電勢將會在任何兩種固體間出現並且是諸如二極體整流現象和熱電效應等的潛在原因。內建場是導致半導體連接處能帶彎曲的原因。明顯的能帶彎曲在金屬中不會出現因為他們很短的遮蔽長度意味着任何電場只在接觸面間無限小距離內存在。

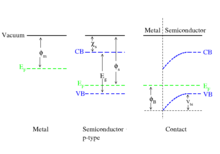
在經典物理圖像中,為了克服勢壘,半導體載子必須獲得足夠的能量才能從費米能階跳到彎曲的導帶頂。穿越勢壘所需的能量是內建勢及費米能階與導帶間偏移的總和。同樣對於n型半導體,當中是半導體的電子親合能(electron affinity),定義為真空能階和導帶(CB)能階的差。對於p型半導體,其中是禁帶寬度,e是基本電荷。當穿越勢壘的激發是熱力學的,這一過程稱為熱發射。真實的接觸中一個同等重要的過程既即為量子力學穿隧。WKB近似描述了最簡單的包括勢壘穿透機率與勢壘高度和厚度的乘積指數相關的穿隧圖像。對於電接觸的情形,空乏區寬度決定了厚度,其和內建場穿透入半導體內部長度同量級。空乏層寬度可以通過解帕松方程式以及考慮半導體內存在的摻雜來計算:
在MKS單位制是淨電荷密度而是介電常數。幾何結構是一維的因為界面被假設為平面的。對方程式作一次積分,我們得到
積分常數根據空乏層定義為界面完全被遮蔽的長度。就有
其中被用於調整剩下的積分常數。這一方程式描述了插圖右手邊藍色的斷點曲線。空乏寬度可以通過設置來決定,結果為
對於0 < x < W,是完全空乏的半導體中離子化的施體和受體淨電荷密度以及是電荷。和對於n型半導體取正號而對於p型半導體取負號,n型的正曲率和p型的負曲率如圖所示。
從這個大概的推導中可注意到勢壘高度(與電子親和性和內建場相關)和勢壘厚度(和內建場、半導體絕緣常數和摻雜密度相關)只能通過改變金屬或者改變摻雜密度來改變。總之工程師會選擇導電、非反應、熱力學穩定、電學性質穩定且低張力的接觸金屬然後提高接觸金屬下方區域摻雜密度來減小勢壘高度差。高摻雜區依據摻雜種類被稱為或者。因為在穿隧中透射係數與粒子質量指數相關,低有效質量的半導體更容易被解除。另外,小禁帶半導體更容易形成歐姆接觸因為它們的電子親和度(從而勢壘高度)更低。
上述簡單的理論預言了,因此似乎可以天真的認為功函靠近半導體的電子親和性的金屬通常應該容易形成歐姆接觸。事實上,高功函金屬可以形成最好的p型半導體接觸而低工函金屬可以形成最好的n型半導體接觸。不幸的是實驗表明理論模型的預測能力並不比上述論斷前進更遠。在真實條件下,接觸金屬會和半導體表面反應形成具有新電學性質的複合物。界面處一層污染層會非常有效的增加勢壘寬度。半導體表面可能會重構成一個新的電學態。接觸電阻與界面間化學細節的相關性是導致歐姆接觸製造製程可重複性為如此巨大的製造挑戰的原因。
實驗特性[編輯]
特徵接觸電阻實驗上定義為J-V曲線在V=0處的斜率,J是電流密度:
- .
接觸電阻的單位因此成為,其中代表電阻單位歐姆。
接觸電阻可以通過比較帶有歐姆表的四探針測量(four-probe measurement)和簡單的兩探針測量結果來粗略估計。在兩探針測量中,測量電流導致同時跨越探針和接觸的勢降,從而這些元件的電阻與真是元間的電阻是串聯而不可分離的。在四探針測量中,一對探針用於注入測量電流同時另一對並聯的探針用於測量跨越元件的勢降。在四探針情形下,沒有通過電壓測量探針的勢降因而接觸電阻降並不包括其中。從兩極法和四極法推導的電阻差值是對接觸電阻合理準確的測量假設探針電阻足夠小而忽略不計。特性接觸電阻可以通過乘以接觸面積來得到。
隨着集成電路製備過程的發展,遠更複雜的接觸電阻測量被使用,最流行的方法即為傳輸線測量)(transmission line measurement)。傳輸線測量的基本思路是描繪類似接觸之間同寬不同長度的條狀電阻值。結果曲線的斜率是塊狀薄膜電阻率(resistivity)的函數而截距即為接觸電阻(resistance)。
歐姆接觸的製備[編輯]
歐姆接觸製備是材料工程里研究很充分而不太有未知剩餘的部分。可重複且可靠的接觸製備需要極度潔淨的半導體表面。例如,因為天然氧化物會迅速在矽表面形成,接觸的性能會十分敏感地取決於製備準備的細節。
接觸製備的基礎步驟是半導體表面清潔、接觸金屬沉積、圖案製造和退火。表面清潔可以通過濺射蝕刻、化學蝕刻、反應氣體蝕刻或者離子研磨。比如說,矽的天然氧化物可以通過蘸氫氟酸(HF)來去除,而砷化鎵(GaAs)則更具代表性的通過蘸溴化甲醇來清潔。清潔過後金屬通過濺射、蒸發沉積或者化學氣相沉積(CVD)沉積下來。濺射是金屬沉積中比蒸發沉積更快且更方便方法但是等離子帶來的離子轟擊可能會減少表面態或者甚至顛倒表面電荷載子的類型。正因為此更為平和且依然快速的CVD是更加為人所傾向的方法。接觸的圖案製造是通過標準平版照相術來完成的,比如剝落中接觸金屬是通過沉積於光阻劑層孔洞之中並稍後取出光阻劑來完成的。沉積後接觸的退火能有效去除張力並引發有利的金屬和半導體之間的反應。
技術角度上重要的接觸類型[編輯]
現代對矽的歐姆接觸比如二矽化鈦鎢通常是CVD製作的矽化物。接觸通常通過沉積過渡金屬然後退火形成矽化物來製造且形成的矽化物通常為非化學計算的。矽化物接觸也可通過直接濺射複合或者離子移植過渡金屬來沉積並退火。鋁是另一種可同時用於n型和p型半導體重要的矽接觸金屬,但並非所有n型矽和鋁都可以形成歐姆接觸,一般而言,n+型矽和鋁較能形成良好的歐姆接觸,與n型或n-型矽則形成schottky接觸,而一般n型矽,摻雜濃度在1016cm-3左右,先鍍Ti接觸矽再鍍上Ag形成歐姆接觸。連同使用其它的反應金屬,鋁接觸通過消耗天然氧化物中的氧來形成。矽化物很大程度上取代了鋁(Al)部分因為高折射材料不太傾向於擴散到不希望的地帶,特別是在隨後的高溫處理過程中。
複合半導體接觸的形成可以理解比矽接觸更為複雜。比如說,砷化鎵(GaAs)表面傾向於丟失砷而且這種砷丟失的趨勢可以通過沉積金屬而被可觀的放大。另外,砷的易揮發性限制了沉積後退火時砷化鎵元件的承受度。砷化鎵及其他複合半導體的一種解決辦法是沉積低禁帶合金接觸層與高摻雜層相對。例如,砷化鎵自己比砷化鋁鎵(AlGaAs)有更小的禁帶帶寬 所以一層靠近它表面的砷化鎵層能促進歐姆行為。總之相比之下,III-V和II-VI半導體歐姆接觸技術比矽歐姆接觸技術發展較緩。
| 材料 | 接觸材料 |
|---|---|
| 矽(Si) | 鋁(Al),鋁-矽,矽化鈦(TiSi2),氮化鈦(TiN),鎢,矽化鉬(MoSi2),矽化鉑(PtSi),矽化鈷(CoSi2),矽化鎢(WSi2) |
| 鍺(Ge) | 銦(In),鎵金合金(AuGa),銻金合金(AuSb) |
| 砷化鎵(GaAs) | 鍺金合金(AuGe) (頁面存檔備份,存於互聯網檔案館),鉛金(PdGe), 鈦Ti/鉑Pt/金Au |
| 氮化鎵(GaN) | Ti/Al/Ti/Au、Pd/Au |
| InSb | In |
| ZnO | InSnO2、Al |
| CuIn1-xGaxSe2 | 鉬(Mo), InSnO2 |
| HgCdTe | 銦(In) |
透明或半透明接觸對於主動矩陣液晶顯示器LCD、光電元件諸如激光二極體(LD)、發光二極體(LED)及光電管是必要的。最流行的選擇是氧化銦錫(ITO),一種通過在氧氣環境下濺射銦-錫(In-Sn)靶形成的金屬。
重要性[編輯]
接觸電阻相關聯的RC時間常數會限制元件的頻率響應。引線電阻的充電與放電高時鐘速率的數碼電子設備能量耗散的主要原因。接觸電阻在非常見半導體製成的低頻和模擬電路中通過焦耳熱的形式導致能量耗散(比如太陽能電池)。金屬接觸製備方法的建立是任何新興半導體科技發展的重要部分。金屬接觸的電遷移與分離成層也是電子元件壽命的限制因素之一。
參考資料[編輯]
- Sze, S.M. Physics of Semiconductor Devices. John Wiley & Sons. 1981. ISBN 978-0-471-05661-4. Discussion of theory plus device implications.
- Zangwill, Andrew. Physics at Surfaces. Cambridge University Press. 1988. ISBN 978-0-521-34752-5. Approaches接觸from point of view of surface states and reconstruction.
參見[編輯]
- The American Vacuum Society (頁面存檔備份,存於互聯網檔案館) has an excellent 接觸short course[永久失效連結] on this topic.
- Journal of the American Vacuum Society、Thin Solid Films (頁面存檔備份,存於互聯網檔案館) and Journal of the Electrochemical Society are journals that publish current research on歐姆contacts.
| |||||||||||||||||
| ||||||||||||




























