后道工序
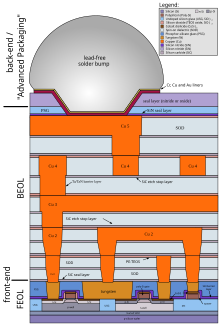

后道工序(back end of line,BEOL)是IC制造的第二部分,其中各个器件(晶体管、电容器、电阻器等)与晶圆上的布线(金属化层)互连。常见的金属有铜和铝。 [1]BEOL通常在晶圆上沉积第一层金属时开始。BEOL包括触点、绝缘层(电介质)、金属层以及用于芯片与封装连接的接合位点。
在最后一个FEOL步骤之后,就会出现一个带有隔离晶体管(没有任何电线)的晶圆。在制造阶段的BEOL部分中,形成接触(焊盘)、互连线、通孔和介电结构。对于现代IC工艺,可以在BEOL中添加 10 多个金属层。
BEOL 步骤:
- 源极和漏极区域以及多晶硅区域的硅化。
- 添加电介质(第一层,下层是预金属电介质(PMD) – 将金属与硅和多晶硅隔离,对其进行CMP处理
- 在 PMD 上打孔,并在其中建立接触点。
- 添加金属层1
- 添加第二个电介质,称为金属间电介质(IMD)
- 通过电介质制作通孔以将较低金属与较高金属连接。通过金属CVD工艺填充通孔。
- 重复步骤 4-6 以获取所有金属层。
- 添加最终钝化层以保护微芯片
1998 年之前,几乎所有芯片都使用铝作为金属互连层。 [2]
BEOL 之后有一个“後段製程”,该工艺不是在洁净室中完成的,通常由不同的公司完成。它包括晶圆测试、晶圆背面研磨、芯片分离、芯片测试、 IC封装和最终测试。
相关[编辑]
参考[编辑]
- ^ Karen A. Reinhardt and Werner Kern. Handbook of Silicon Wafer Cleaning Technology 2nd. William Andrew. 2008: 202. ISBN 978-0-8155-1554-8.
- ^ Copper Interconnect Architecture.
进一步阅读[编辑]
- Chapter 11: Back End Technology
 . Prentice Hall. 2000: 681–786. ISBN 0-13-085037-3.
. Prentice Hall. 2000: 681–786. ISBN 0-13-085037-3. - Chapter 7.2.2: CMOS Process Integration: Backend-of-the-line Integration. Wiley-IEEE. 2010: 199–208 [177–79]. ISBN 978-0-470-88132-3.
